蔡司透過Crossbeam Laser FIB-SEM 以量級化速度加快半導體封裝失效分析
前言:
蔡司Crossbeam Laser成功將飛秒雷射、鎵離子FIB與場發射電子顯微鏡整合成單一工具,提供最快速的指定區域橫切面工作流程
2020年2月12日--蔡司(ZEISS)今日宣布推出蔡司Crossbeam Laser,專為指定區域使用的聚焦離子束掃描式電子顯微鏡(FIB-SEM)全新系列解決方案,可大幅提升先進半導體封裝失效分析及製程優化的速度。蔡司Crossbeam Laser系列結合飛秒雷射的速度、鎵離子(Ga+)光束的準確度以及掃描式電子顯微鏡的奈米級影像解析度,為封裝工程師與失效分析師提供最高影像效能及最快速的橫切面解決方案,同時將樣品損壞降至最低。
在獨特的架構下,蔡司Crossbeam Laser系列可以快速掃描出深埋的封裝互連物,如銅柱焊錫凸塊與矽穿孔(TSVs),以及裝置的後段製程(BEOL)與前段製程(FEOL)結構,整體過程只需幾分鐘,反觀其它方式則需耗時數小時、甚至數天,同時還能在真空狀況下將影像缺陷降至最低,並依舊維持樣品的品質。除了提供失效分析外,蔡司Crossbeam Laser系列也可協助進行結構分析、架構分析、逆向工程、FIB斷層掃描與穿透式電子顯微鏡(TEM)的樣品準備。目前多套蔡司Crossbeam Laser系統已出售給大型的全球電子製造商。

圖一_蔡司Crossbeam Laser FIB-SEM為先進半導體封裝加速封裝失效分析及製程優化。透過將飛秒雷射、鎵離子FIB與場發射電子顯微鏡整合成單一工具,以提供最快速的指定區域橫切面工作流程。
3D封裝所需的失效分析新方法
行動與高效能裝置對微型化和更高互連密度的需求與日俱增,已經帶動一波創新潮,並實現微矩與多晶片架構的可能。這些設計不但在封裝互連尺寸越縮越小,更逐漸地將它們推進三度空間。與此同時,深埋在這些封裝裡的新型態缺陷也開始出現,它們可能影響良率與可靠性,因此必須迅速找出並予以排除。
行動與高效能裝置對微型化和更高互連密度的需求與日俱增,已經帶動一波創新潮,並實現微矩與多晶片架構的可能。這些設計不但在封裝互連尺寸越縮越小,更逐漸地將它們推進三度空間。與此同時,深埋在這些封裝裡的新型態缺陷也開始出現,它們可能影響良率與可靠性,因此必須迅速找出並予以排除。
在失效分析工作流程中,進行非破壞性分析是優化封裝製程與提升封裝良率的第一步。此時會採用蔡司Xradia Versa 3D X-ray顯微鏡等儀器,以非破壞性方式顯現缺陷的位置,接著進行破壞性的物理失效分析(PFA)技術,以判定並解決失效的根本原因。如今,封裝互連與半導體BEOL尺寸已相互交會。PFA常用的機械式橫切面,現在已被要求必須迅速且精確到達深埋的結構與缺陷。此外,在半導體BEOL中採用像是極低介電係數等易碎材料,導致橫切面所引發的缺陷數量越來越多,這些因樣品製備造成的缺陷很難與晶片及封裝互動所造成的真正缺陷作出區別。
電漿FIB(PFIB)是另一種橫切面方法,但較飛秒雷射慢了1萬倍。正如許多封裝FA應用的要求,其在需求範圍內速度還是太慢,不足以解決大於或等於0.5 立方毫米的大體積切割。此外,PFIB缺乏最高品質TEM樣品準備所需的解析度,並且會引發半導體封裝常用的碳質材料產生帶狀缺陷。獨立式的雷射系統雖然可以提供快速切割,但可能會產生較大的受熱影響區域,同時增加目標區域損害的可能性與移除後加缺陷所需的研磨時間。缺乏與FIB-SEM的整合也讓FA工作流程變慢且效率降低,同時因為分析前曝露大氣中導致有可能氧化的風險。
蔡司製程控制解決方案(PCS)暨蔡司半導體製造技術(Carl Zeiss SMT)負責人Raj Jammy表示:「封裝的世界已經來到一個轉折點,單一矽中介層密度接近一百萬個輸入/ 輸出(I/O),而縮小互連物已經開始反映在晶圓製造上,且堆疊的情況四處可見,包含在裝置本身裡、在封裝層裡,以及在印刷電路板裡。當一個零件失效時,會讓故障隔離與失效分析更加困難。蔡司Crossbeam Laser系列旨在減輕FA工程師的壓力,在單一儀器內結合速度、精準度與高解析影像,提供在同類機型表現最佳的系列,且在樣品到結果有革命性速度上地進步。」
蔡司Crossbeam Laser系列提供最佳的PFA解決方案,可大幅改善獲得結果所需的時間,並提供最高的影像效能,其特色包含:
• 飛秒雷射用於提供大型立體結構的移除,並最小化可能造成的缺陷(僅30分鐘即可移除最高達一立方毫米的矽,反觀其它方式則需耗時數小時、甚至數天)。
· 蔡司的Gemini鏡筒技術可提供最高影像品質與解析。
· Ga+ FIB可提供結合100nA的高速研磨與500V的精細拋光,以減少非晶化情況。
· 使用FIB解析度(最小可到3奈米)可精準定位最後位置。
· 具備獨立的雷射室,和主要的拍攝腔體分開,以便隔離切割污染物,保持最高解析度的影像能力,並同時降低維護成本。
· FIB-SEM與雷射室之間樣品轉移便利快速,且不會破壞真空。
· 雷射配置適用許多材料,包括碳化矽與玻璃。
• 飛秒雷射用於提供大型立體結構的移除,並最小化可能造成的缺陷(僅30分鐘即可移除最高達一立方毫米的矽,反觀其它方式則需耗時數小時、甚至數天)。
· 蔡司的Gemini鏡筒技術可提供最高影像品質與解析。
· Ga+ FIB可提供結合100nA的高速研磨與500V的精細拋光,以減少非晶化情況。
· 使用FIB解析度(最小可到3奈米)可精準定位最後位置。
· 具備獨立的雷射室,和主要的拍攝腔體分開,以便隔離切割污染物,保持最高解析度的影像能力,並同時降低維護成本。
· FIB-SEM與雷射室之間樣品轉移便利快速,且不會破壞真空。
· 雷射配置適用許多材料,包括碳化矽與玻璃。
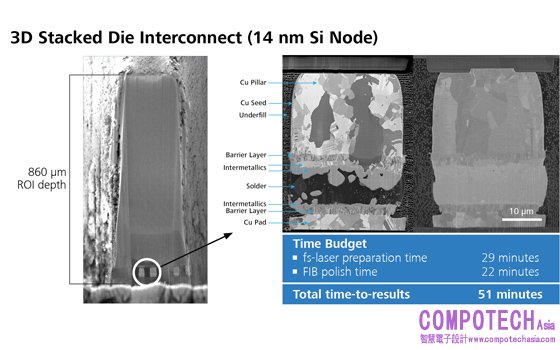
圖二_蔡司Crossbeam Laser FIB-SEM提供埋在860微米深的銅柱微凸塊的快速橫切面,其具有高品質的影像效能,而獲得結果的所需時間僅不到1小時。
蔡司Crossbeam Laser結合蔡司Xradia Versa XRM,讓標準的FA工作流程如虎添翼,將能提升FA的成功率,並加速解決問題的速度。
欲了解更多關於蔡司Crossbeam Laser系列的訊息,請瀏覽www.zeiss.com/pcs
關於蔡司(ZEISS)
蔡司為一間領先全球的科技公司,經營領域涵蓋光學與光電。在上一個會計年度中,蔡司集團旗下四個業務領域的年度營收超過64億歐元,分別為半導體製造技術、工業品質與研究、醫療技術及消費市場(截至2019年9月30日)。
蔡司為客戶開發、生產並銷售各種高度創新的解決方案,涵蓋工業量測與品管、生命科學與材料研究的顯微鏡解決方案,以及用於眼科及顯微外科診斷與治療的醫療技術解決方案。蔡司同時也是全球頂尖微影光學的代名詞,被廣泛運用在晶片產業的半導體元件製造。全球市場對於眼鏡鏡片、相機鏡頭及望遠鏡等引領潮流的蔡司產品皆有其需求。
將旗下品牌鎖定於數位化、醫療及智慧製造等未來成長領域,蔡司以強勁的聲勢形塑光學與光電產業的未來面貌。蔡司在研究與開發的長期投資為其技術與市場奠定領先優勢與持續擴展的基礎。
蔡司旗下有超過3.1萬名員工,經營版圖遍及近50國,擁有約60家行銷與服務據點,30個生產基地及約25個研發中心。蔡司於1846年創立於德國耶拿市,總部位於德國奧伯科亨市(Oberkochen)。卡爾蔡司基金會(Carl Zeiss Foundation)是德國規模最大的基金會之一,致力推動科學研究,也是卡爾•蔡司公司(Carl Zeiss AG)的唯一股東。
欲了解更多資訊,請瀏覽網站www.zeiss.com。
關於半導體製程技術(Semiconductor Manufacturing Technology;SMT)公司
憑藉廣泛的產品組合與專業能力,蔡司旗下的半導體製程技術公司負責各種微晶片製造的關鍵製程,其產品包含半導體製造光學設備(主要為微影光學)及為半導體製程提供光罩系統與製程控制解決方案。透過蔡司在半導體製程的技術,業界生產的微晶片日趨微縮、功能更強大、更具能源效益且價格更實惠。隨著各種電子應用持續的改進,帶動科技、電子、通訊、娛樂、行動及能源等領域的全面提升。
憑藉廣泛的產品組合與專業能力,蔡司旗下的半導體製程技術公司負責各種微晶片製造的關鍵製程,其產品包含半導體製造光學設備(主要為微影光學)及為半導體製程提供光罩系統與製程控制解決方案。透過蔡司在半導體製程的技術,業界生產的微晶片日趨微縮、功能更強大、更具能源效益且價格更實惠。隨著各種電子應用持續的改進,帶動科技、電子、通訊、娛樂、行動及能源等領域的全面提升。
半導體製程技術公司的總部設立於德國奧伯科亨市(Oberkochen),分支據點包括德國的耶拿市(Jena)、羅斯多夫市(Rossdorf)與威茲拉爾市(Wetzlar);以色列巴列夫市(Bar Lev)及美國加州普萊森頓市(Pleasanton)與麻州皮博迪市(Peabody)。