賀利氏推出全球首創可替代金線AgCoat Prime鍍金銀線
前言:
完美整合金和銀的雙重優勢 助記憶體廠商降低成本、減少人力並縮短生產時間
2020年9月23日--在記憶體和高階智慧卡的半導體封裝製程中,打線接合是目前應用最廣泛的技術,其中打線使用的金屬材料仍以金線為主流;而隨著5G技術的發展,記憶體容量需求增加,再加上市場競爭激烈,廠商需要高性價比的材料解決方案,因此半導體與電子封裝領域材料解決方案領導廠商賀利氏在2020年台灣國際半導體展(SEMICON Taiwan)期間展示AgCoat Prime鍍金銀線,完美整合金和銀的雙重優勢,成為全球首款可真正替代金線的鍵合線(bonding wire)。更多訊息歡迎於9月23日至25日蒞臨台北南港展覽館一樓(材料專區)I2300 賀利氏攤位參觀。

昂貴的金價對封裝業者而言一直都是艱鉅的挑戰,但直接使用銀線封裝卻非理想替代方案,因銀線開封後壽命較短,且鍵合過程(bonding process)中需在惰性氣體保護下燒球(FAB),存在一定的企業成本。賀利氏電子產品經理James Kim 表示:「針對產業痛點,賀利氏研發首款取代昂貴金線的解決方案AgCoat Prime,能提供媲美金線的高性能,並降低成本。作為領先的鍵合線金屬材料領導廠商,我們將持續為產業客戶提供新興解決方案。」
AgCoat Prime的參數規格與金線一致,鍵合過程中不需使用惰性氣體,廠商因此能繼續採用既有的生產設備。此外,AgCoat Prime開封後壽命長達60 天,提供更長的不間斷鍵合線,從而優化生產效能。相較金線,AgCoat Prime的金屬間化合物(IMC)生長更緩慢,擁有更佳的高溫儲存(HTS)和溫度循環(TC)能力,且不會出現柯肯道爾效應(Kirkendall Effect)(請見下圖)。
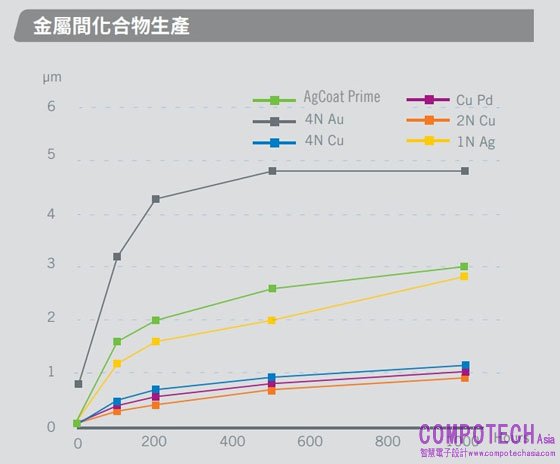
圖:金屬間化合物生產對比
AgCoat Prime的關鍵優勢:
• MTBA(技術人員平均故障排除週期)可與金線匹敵
• 鍵合過程中無惰性氣體保護也能燒球
• 開封後使用壽命達60 天,比銀合金線更長
• 提升第二焊點的作業性
• 相比金線,高溫儲存(HTS)和溫度循環(TC)能力表現更好
• 直接利用客戶現有生產設備,無需任何額外的固定資產投資
• 可以使用既有鍵合機(ball bonder)
• 金屬間化合物的生長比金線緩慢
演講資訊:
2020年台灣國際半導體展期間,賀利氏將出席TechXPOT 創新技術發表會,進一步介紹AgCoat Prime在記憶體、LED及智慧卡封裝上的應用。
地點:台北南港展覽館一樓K2786攤位
時間:9月23日(三)下午 3:00至3:20
關於賀利氏
總部位於德國哈瑙市的賀利氏是一家全球領先的科技集團。公司在1660 年從一間小藥房起家,如今已發展成為一家擁有多元化產品和業務的家族企業,業務涵蓋環保、電子、健康及工業應用等領域。憑藉豐富的材料知識和領先技術,賀利氏為客戶提供創新技術和解決方案。
2019 年財報,賀利氏的總銷售收入為224 億歐元,在40 個國家擁有約14,900名員工。賀利氏被評選為「德國家族企業十強」,在全球市場上佔據領導地位。
大中華地區是賀利氏最為重要的三個市場之一,公司在這一地區的發展已有超過40 年的歷史。目前,賀利氏在大中華地區一共擁有2,700多名員工及20家公司。