伴隨CPU、GPU、FPGA等高效能運算(HPC)晶片性能要求持續提升,覆晶封裝(Flip Chip;FC)、層疊封裝(Package on Package;PoP)等傳統封裝技術已不敷使用,使2.5D/3D封裝技術需求逐漸增加,吸引半導體製造業者積極布局,其中,IDM與晶圓代工業者2.5D技術發展相對委外半導體封測(OSAT)業者成熟、完整,也具有多年量產經驗,3D封裝技術則將陸續開花結果。
DIGITIMES Research分析師陳澤嘉指出,覆晶封裝雖是現行晶片封裝主流技術,然2.5D/3D封裝提供較覆晶封裝7~8倍以上的I/O數增量,以及更高密度整合更多晶片/模組,有助晶片提升效能、改善功耗等,增加HPC晶片業者採用2.5D/3D技術的誘因。具體來看,NVIDIA與超微(AMD) CPU與GPU、英特爾(Intel)與賽靈思(Xilinx) FPGA等多為2.5D封裝,而英特爾Lakefield CPU更是首個以3D封裝的CPU。
HPC晶片所催生的2.5D/3D封裝商機吸引IC製造業者積極布局,其中,英特爾、三星電子(Samsung Electronic)與台積電已具成熟的2.5D封裝經驗;3D封裝部分,英特爾已量產Foveros技術,三星與台積電則將在2021~2022年陸續量產。日月光、艾克爾(Amkor)等OSAT業者雖布局2.5D/3D封裝,但技術方案仍不若IDM與晶圓代工業者完整,然逐漸強化中。
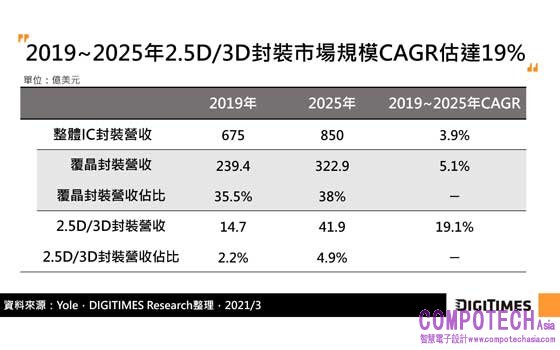
【關於DIGITIMES Research】
DIGITIMES成立於1998年,為大中華地區報導科技產業全球供應鏈、區域市場、科技應用及市場趨勢首屈一指的專業媒體平台。DIGITIMES Research提供貫穿產業上中下游與終端市場的研究數據、產銷資料與專業評析,並藉由諮詢建議帶給客戶產業趨勢與前瞻價值。
【DIGITIMES會員服務】欲了解更多資訊,歡迎洽詢https://www.digitimes.com.tw/





